株式会社東レリサーチセンター(所在地:東京都中央区日本橋本町一丁目7 番2 号、社
長:真壁芳樹、以下「TRC」)は、300 mm ウェーハ対応の最新型水銀プローバ※1 による迅
速な電気特性評価と、DLTS 装置※2 による欠陥評価を組み合わせ、先端半導体向け絶縁膜
の総合評価サービスを開始しました。従来の特性評価において必須であった評価用デバイ
スを作製することなくウェーハ状態のまま各種特性を評価できるため、開発サイクルの大
幅な短縮が可能となります。
【背景】
生成AI の普及に伴い、データセンターの低消費電力化・高性能化が重要な課題となっています。これを実現するには、絶縁膜の絶縁性の向上および欠陥の低減が不可欠であ
り、この絶縁膜品質が先端半導体の性能や寿命を左右します。先端半導体では絶縁膜が
1 nm 以下~数 nm 程度と極薄であり、電気特性・欠陥評価には高度な専門性に加え、従
来は評価用デバイスの作製に時間を要していました。
【開発した技術】
これに対してTRC はこの度、300 mm ウェーハ対応の最新型水銀プローバにより電極形成不要でウェーハのまま基礎電気特性を評価、さらにDLTS により絶縁膜中・界面欠
陥を評価可能な一貫体制を整備し、迅速な材料スクリーニングと開発効率化を支援する
体制を整えました。
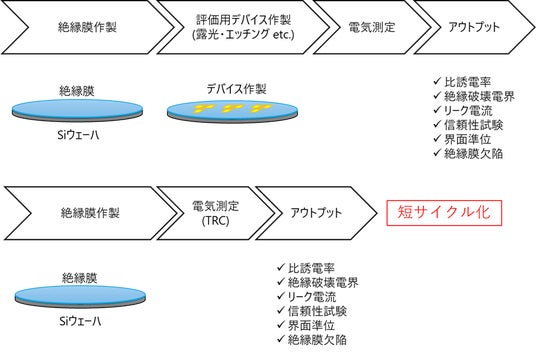
図1 絶縁膜の電気特性評価の流れ:上段 従来評価プロセス、下段 新規評価プロセス
表1 代表的なアウトプット項目

【本サービスの特徴】
1. 最新の水銀プローバ装置の導入新たに導入した300 mmウェーハ対応の最新型水銀プローバにより、電極形成不要で、絶縁膜を成膜したウェーハをそのまま測定可能です。従来必要であった電極形成プロセスを省略できるため、材料開発から信頼性スクリーニングまでの期間短縮に貢献します。代表的な評価項目は以下のとおりです。
・比誘電率
・リーク電流
・破壊電圧
・絶縁信頼性試験(TDDB※3など)
2. 絶縁膜中および界面欠陥分析の高精度化
最新のDLTS装置を活用したTRC独自の技術開発により、極薄絶縁膜における膜中または半導体界面の電気的欠陥を高い再現性で評価可能としました。測定条件の最適化や電極構造の工夫により、従来の汎用電気測定に比べて定量性・活性化エネルギー分解能の向上を実現しました。
【今後の展開】
東レリサーチセンターは電気特性評価の機能強化に加え、従来から提供している各種分析(材料物性評価、構造・化学分析 など)と組み合わせ、開発段階や課題に合わせた総合的な分析サービスを提供します。【用語解説】
※1 水銀プローバ:水銀を用いてウェーハ表面に一時的な電極を形成し、電気特性を測定する装置。※2 DLTS(Deep Level Transient Spectroscopy、過渡容量分光法):電気特性の時間変化を解析することで、半導体や絶縁膜中に存在する欠陥の量を評価する手法。欠陥の量はデバイス性能を左右する重要な指標の一つである。
※3 TDDB(Time Dependent Dielectric Breakdown、経時絶縁破壊):一定電圧下で絶縁膜が破壊されるまでの時間を多数回測定し、その結果を統計処理することで、絶縁膜の耐久性および長期信頼性を評価する試験。












































